Closing the Loop: CMP Process Control Methodology and Implementation

Brian Brown
Applied Materials



Brian Brown
Applied Materials


Knut Gottfried
Fraunhofer-Institute for Elektronic Nanosystems ENAS


Jin Goo Park
Hanyang University


Cass Shang
GrandiT Co. Ltd(中巨芯)


Jihoon Seo
Clarkson University, Department of Chemical and Biomolecular Engineering


Yingjie Wang
Fudan University


Yurong Que
HLMC


Qingxuan Hong
HLMC


WenSheng Xu
HLMC


Chenwei Wang
Hebei University of Technology


Minghui Qu
Hebei University of Technology


Chun Lu
Merck


Lifei Zhang
Tsinghua University


Yi Xian
HLMC


Pengfei Wu
Hebei University of Technology


Yan Han
Hebei University of Technology


Fu Luo
Hebei University of Technology


Chengxin Wang
Tsinghua University
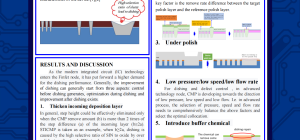

Yu Yang
HLMC
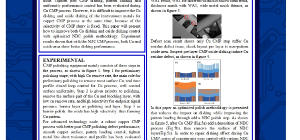

Lei Zhang
HLMC
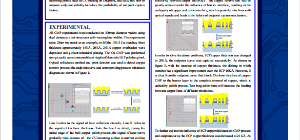

Yuanyuan Meng
HLMC


Shaojia Zhu
HLMC


Weiran Sun
HLMC


Ran Yin
Applied Materials


Yifeng Zheng
Applied Materials


Kun Zhang
Applied Materials


Na Xiao
Applied Materials


Huijun Zhang
Applied Materials


Ye Wang
Hebei University of Technology


Pingyuan Lu
Applied Materials


Yongbin Wei
Applied Materials


Shaopeng Zhang
Applied Materials


Yunlong Wu
Applied Materials
© 2022 SEMI 云官网. All Rights Reserved.